Soft-etching
ATC-IM Ion Milling System from AJA International, USA
기판 냉각 및 SIMS end point detection 기능이 있는 다양한 크기의 physical etching tool. 최대 직경 22 cm의 RF 이온 소스 및 DC 이온 소스. 대면적의 소스를 위한 편리한 슬라이드 레일 액세스.
General Information
AJA International ATC-IM Ion Milling System은 고객 요구 사항에 따라 다양한 구성으로 제작되는 다목적 장비입니다. 챔버는 원통형 또는 박스 스타일, HV 또는 UHV를 선택할 수 있습니다. SIMS endpoint detection은 AJA의 고유한 SIMS-IS isolation system과 함께 선택 사항으로, 이를 통해 main chamber가 vent될 때마다 SIMS head/detector를 진공 상태로 유지할 수 있습니다. 시스템은 computer control과 load-lock, auto-loading, multi-substrate cassette, mask exchange로 구성될 수 있습니다.

AJA는 회전, 수동/전동식 입사각 조정, 가열, 수냉 / LN2 냉각, 후면 가스 냉각, 전기 절연 또는 바이어싱과 같은 기능을 갖춘 다양한 기판 홀더를 제조합니다. AJA International 이온밀링시스템은 nano pattern delineation에서 bulk wafer planarization에 이르는 광범위한 어플리케이셔에 맞게 구성될 수 있습니다. AJA는 고객 요구에 따른 그리드 재료 및 곡률(curvature)을 사용하여 그리드가 있거나 없는 RF 이온소스 또는 DC 이온 소스, 장비에 포함된 적절한 safety gas box와 함께 불활성 및 반응성/부식성 공정 가스를 모두 사용하도록 제작하고 있습니다.
TYPICAL RATE / UNIFORMITY DATA
기판에 대한 입사각은 속도와 균일성 분포도에 영향을 줍니다. 편심, 오프 축 밀링의 많은 이점 중 하나는 유사한 균일한 분포도를 얻는 데, 일반적으로 비용이 많이 드는 소스를 필요로 하는 더 큰 웨이퍼의 균일한 에칭 성능을 달성하는 만큼의 줄어든 이온 소스 크기입니다. 각도 입사는 또한 제거속도를 향상시키면서 기판의 손상을 줄입니다.
Milling angle 외에도 이온 빔 에너지는 밀링 속도(milling rate)의 핵심 구성 요소입니다. 선택된 이온 소스에 따라 이온 에너지는 50-1200eV로 다양하여, 다양한 밀링 응용 분야에 사용할 수 있습니다. 더욱 heavy한 밀링이 필요한 경우, 일반적으로 더 큰 ion energy가 필요합니다. 낮은 이온 에너지는 더욱 민감한 기재의 밀링에 적당합니다.
밀링 공정 중에 기재의 온도 증가는 밀링 속도와 재료에 영향을 미칠 수 있습니다. 균일한 속도와 분포도를 유지하고 기판 손상 또는 원치 않는 변형을 방지하기 위해 밀링 프로세스 동안 기판의 온도를 안정화하는 것이 바람직합니다.

Typical milling profile:
각진 격자형 Kaufman 스타일 이온 소스(an angled and gridded Kaufman style ion source)를 사용하여 6" Ø Si 웨이퍼상에 SiO2로 ±2% 균일한 분포도를 제공하는 전형적인 밀링 프로파일을 제공합니다. 이 프로세스는 또한 헬륨 가스 냉각 (helium gas backside cooling) 및 프로그래밍 가능한 working distance 조절이 가능한 BSG200 회전 웨이퍼 테이블을 활용했습니다.
"Typical milling profile yielding ± 2% uniformity with SiO2 on a 6" Ø Si wafer and using an angled, gridded Kaufman style ion source. This process also utilized a BSG200 rotating wafer table equipped with helium gas backside cooling and programmable working distance adjustment."
ION SOURCES
AJA는 업계에서 유통되는 주요 이온 소스를 제작하고 이를 모든 ATC 시리즈 이온 밀링 시스템에 활용하고 있습니다. AJA 시스템에는 고속 어플리케이션을 위한 DC / RF 카우프만 스타일 소스 (DC/RF Kaufman style source), 또는 예민하고 저 에너지 어플리케이션을 위한 접지 그리드가 있는 용량성 / 유도성 결합의 RF 이온 소스(capacitively / inductively coupled RF ion source)가 장착되어 있습니다. DC 소스는 일반적으로 비반응성 밀링(non-reactive milling, Ar only)에 사용되며 노출된 필라멘트 중화(filament neutralization)를 포함합니다. RF 이온 소스는 불활성 및 반응성 가스와 호환됩니다. 응용 분야에 따라 기판에 대한 직접 또는 각도 입사(direct or angular incidence)를 위해 소스를 챔버에 놓을 수 있습니다. 사용 가능한 모델은 다음과 같습니다:
Leis Plasma/Ion Source
The compact, cost effective, AJA designed and manufactured LEIS sources deliver moderate current density and are suitable for continuous Ar, O2 and N2 operation. These sources can be equipped with AJA's unique in-situ tilting feature which allows for source head angle adjustment without breaking vacuum. The capacitively coupled LEIS source is ideal for low energy milling applications (50-80 eV) and is capable of 10-15% dissociation of N2 and O2.


CCR Copra ICP RF Ion Source
The unique CCR COPRA Quasi-Neutral Plasma/Ion Source is a patented, capacitively/inductively coupled plasma/ion source able to deliver energies up to 200 eV at high currents. These sources are available from 75-400 mm grid Ø and feature an integrated RF matchbox. They are suitable for many reactive gases and are capable of 80-90% dissociation of N2 and O2.
K & R Gridded RF and DC Ion Sorces and Neutralizers
Both DC, filament style, and filamentless RF style, gridded ion sources with variable ion energies up to 1200 eV are available. DC ion sources are suitable for Ar and light O2 service and are equipped with exposed filament neutralization. RF ion sources with protected plasma bridge neutralizers are utilized for reactive gases.

Hollow cathode neutralizer mounted on retractable slide rail

Power supply, 200-1200 eV
SUBSTRATE HOLDERS - COOLED / HEATED
AJA는 모든 ATC-IM 이온 밀링 시스템용 기판 홀더를 설계, 제조합니다. 일반적인 이온 밀링 프로세스에는 샘플 냉각을 포함하고 있습니다. 이온 밀링 중에 기판을 가열하면 비선형 에칭 속도(non-linear etch rate)에서 리쏘그래피 레지스트(lithographic resist)에 사용되는 고분자의 원치 않는 가교결합(cross linking)에 이르기까지 바람직하지 않은 결과가 발생할 수 있습니다. 경우에 따라 화학적 및 물리적 에칭(RIBE)의 조합을 달성하기 위해 가열이 필요할 수 있습니다.
AJA UNO Series Substrate Holders
The AJA UNO Series Substrate Holders can accommodate substrates up to 6" in Ø with water cooling, rotation, and the ability to tilt up to ± 180°. Substrates attach directly to the water cooled surface to maintain temperature stability during the milling process. A retraction system with a convenient slide rail and programmable, motorized incident angle control to within 0.1° is available.
The AJA UNO-SM-HCC Series Substrate Holders feature heating and cooling and reactive gas injection at the wafer surface along with programmable, motorized, incident angle adjustment. Both versions are vacuum load-lock compatible.

for 4” x 4" substrates, 5-200°C, with programmable, motorized tilting and suitable for reactive gases including Cl.

with manual, incident beam angle adjustment,
motorized substrate rotation and water cooling.

Holder with slide rail
The AJA BSG-200 Series Substrate Holder
The AJA BSG-200 Series Substrate Holder is designed to handle wafers or similar planar substrates up to 200 mm in diameter and features direct backside He, Ar or N2 gas cooling while rotating. A peripheral weight ring around the outer edge of the substrates help to maintain a 2 orders of magnitude higher backside gas pressure for optimal heat transfer to the water cooled platen. This design is also load-lock compatible.
Shielding of surrounding materials and weight rings can be provided with compatible metal, ceramic or TiNx coatings to prevent substrate contamination from the substrate holder.
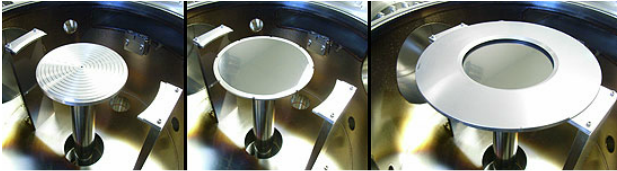
Features backside gas cooling. Center: Shown with mounted silicon wafer in transfer ring.
Right: complete assembly with weight ring in place.
PHASE II-IM COMPUTER CONTROL
AJA Labview 기반 Phase II-IM 컴퓨터 제어 시스템은 모든 ATC-IM 이온 밀링 시스템에 사용됩니다. 이 간단하고 사용자 친화적인 제어 시스템은 single 7" high x 19" wide 랙 마운트 하드웨어 모듈에 연결된 19"rack drawer 의 대형 평면 스크린 노트북을 활용합니다. 하드웨어 모듈의 백 패널에는 시스템의 모든 기능에 인터페이스하는 커넥터가 있습니다.
Phase II-IM control system을 통해 사용자는 수동이나 자동으로 processing mode"에서 작동할 수 있습니다. “Automated processing mode”에서 사용자는 'layer'를 디자인하고 이는 컴파일되어 'process'로 저장됩니다. 시스템은 비밀번호로만 액세스할 수 있는 고유한 사용자 이름을 최대 104개까지 허용하고 저장된 프로세스의 예기치 않은 손상을 방지하는 데 도움이 됩니다.
Standard Phase II-IM control system은 이온 소스 파워서플라이와 진공 펌프, 셔터, 프로세스 가스, 옵션의 스퍼터링 소스, 관련 RF / DC 발생장치, 기판 틸트 및 rotation control, SIMS end point detector와 인터페이스하여 end point에 도달하면, 프로세스를 중지합니다. Setpoint에 도달하지 못해도 프로세스가 중단됩니다. 데이터 로깅은 Microsoft ExcelTM에 다운로드된 프로세스 데이터와 함께 조정 가능한 refresh rate가 특징입니다.

Large screen laptop on convenient slide drawer
for Labview based ATC system computer control.
Replacement laptops are always in stock at AJA.

Phase II-IM PLC in compact 4U rack mount case.
This module is fitted from the outset with all receptacles
for quick field retrofits/upgrades.
SYSTEM OPTIONS


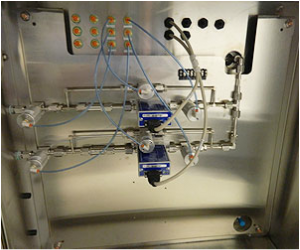

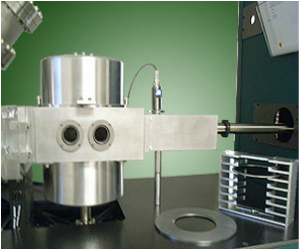
Loading

H2O Sensitive Applications

Password Protected, Encrypted Computer
Control

Pressure Control for Reactive Gas or
Multi- tasking Systems Requirements

full range gauge, vacuum isolation optional

Non-Hazardous Gas Boxes